电子制造是电子产品或系统从硅片等原料开始到产品系统的物理实现过程,可分为半导体制造与电子封装两大部分。电子产品的制造过程大致如图4-1所示。图中被椭圆框包含的部分称为电子封装(electronic packaging),而晶片的制造则称为半导体制造(semiconductor manufacture)[2]。
电子封装是根据电路图,将裸芯片、陶瓷、金属、有机物等物质制造成芯片、元件、模组、板卡、电路板,最终组装成电子产品的整个过程。
图4-2所示为封装分级[3]。从中可以看到,由半导体材料(硅片)制作出一个个的有特定功能的晶片(chip)并不是一个孤立的东西,它必须同其他元件通过输入输出(I/O)进行互连才能发挥功能。封装技术(packaging)就是将一个或多个晶片有效地、可靠地封装和组装起来。软钎焊技术则是电子封装实现互连的最核心的技术。
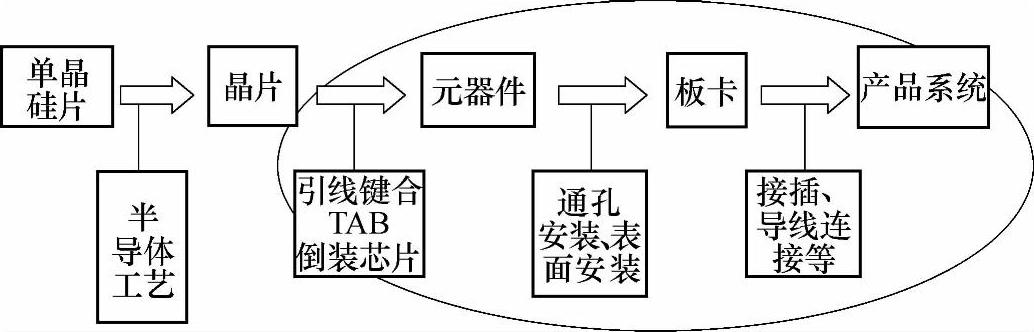
图4-1 电子产品的制造过程 Fig.4-1 A process of physical actualization for electronic products
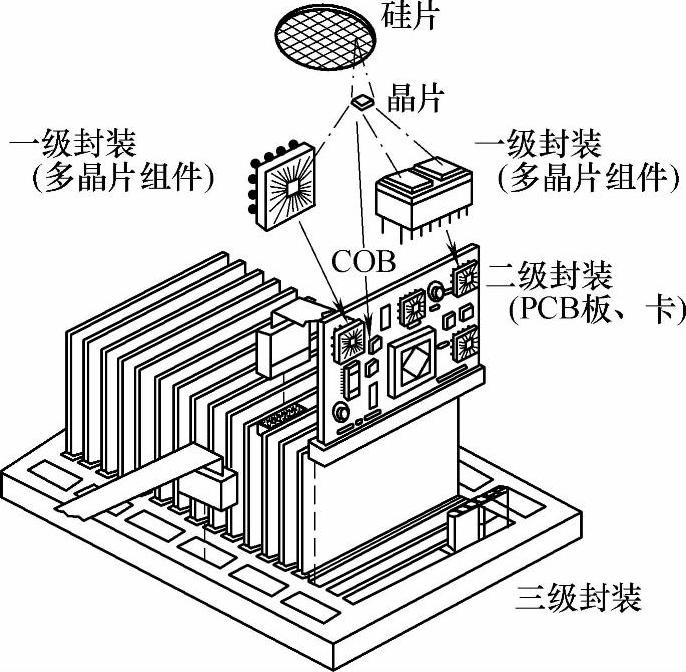
图4-2 封装分级 Fig.4-2 Packaging hierarchy(https://www.xing528.com)
电子封装可分为晶片级封装(零级封装)、器件封装(一级封装)、板卡组装(二级封装)和整机的组装(三级封装)。通常把零级和一级封装称为电子封装(技术),而把二级和三级封装称为电子组装(技术)。随着倒装芯片封装技术的大量应用,一级和二级封装技术之间的界限已经模糊了。
零级封装就是晶片级的连接。通常晶片级的连接方法有引线键合(wire bonding)、载带自动键合(Tape Automated Bonding,TAB)和凸点植入(bump)。这三种技术中以倒装芯片的凸点互连提供的封装密度最高,其中以软钎料凸点的倒装芯片封装技术应用最为广泛。
一级封装就是元器件的封装。它是电子封装中最活跃、变化最快的领域。一级封装的种类繁多、结构多样。无论何种封装结构,均要适应各种软钎焊组装工艺。图4-3所示为几种IC封装的形式。
二级和三级封装就是将IC、阻容元件、接插件以及其他的元器件安装在印制电路板上并总成为整机的技术。前者主要实现板卡的制造,为二级封装;后者主要完成多个板卡总成为整机,为三级封装。
二级封装主要有两大技术:通孔组装技术(Through Hole Technology,THT)和表面组装技术(Surface Mounting Technology,SMT)。由于SMT技术的优点非常突出,因此已成为电子生产领域里的主流技术,直到现在还垄断着电子组装的生产。前几级的封装都以满足SMT技术作为封装的规范。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




