1.数字集成电路概述
数字集成电路是指那些基于布尔代数的公式及规则,能对二进制数进行布尔运算的集成电路。数字集成电路是输入和输出满足一定的逻辑关系,且能实现一定逻辑功能的集成电路,这些逻辑功能包括数字逻辑运算、存储、传输及转换等。数字集成电路是所有数字电子系统的硬件基础。
数字集成电路由最基本的门电路组成,因此可以按每个芯片上集成的门电路个数或元器件个数表征该集成电路的集成度。目前普遍按集成度把数字集成电路分为6类,见表11-2。从1958年出现第1只集成电路芯片到现在,数字集成电路已进入了3G(1G=109)时代,即单片集成度达到1G个晶体管,工作速度达到1×109MHz,最高数据传输速率达到1Gbit/s,并且正在迈向3T(1T=1012)时代。
表11-2 数字集成电路的集成度分类

按照集成电路的逻辑功能,数字集成电路可分为组合(逻辑)电路和时序(逻辑)电路。按照芯片的用途,数字集成电路可分为通用集成电路(如市售的各种通用小、中、大、超大规模集成电路产品)、可编程逻辑器件(如PROM、EPROM、PAL、CPLD、FPGA等)、半定制集成电路(如门阵列、标准单元等构成的集成电路)和全定制专用集成电路(ASIC)。
2.数字集成电路测试原理
数字集成电路测试原理如图11-5所示,其基本方法是根据输入激励量和输出响应量来判断集成电路的故障情况。输入激励是对电路所施加的一组输入信号值(测试集),是为了确定电路中有无故障。
故障检测和故障诊断的首要问题是测试图形的生成。测试生成过程要能迅速准确地得到测试码,并且能判断测试码的有效性,还要保证测试码尽量简单,必须讨论测试码与测试图形的各种生成方法和集成电路的各类故障模型。
首先介绍测试向量、测试图形、测试集等几个术语的定义。
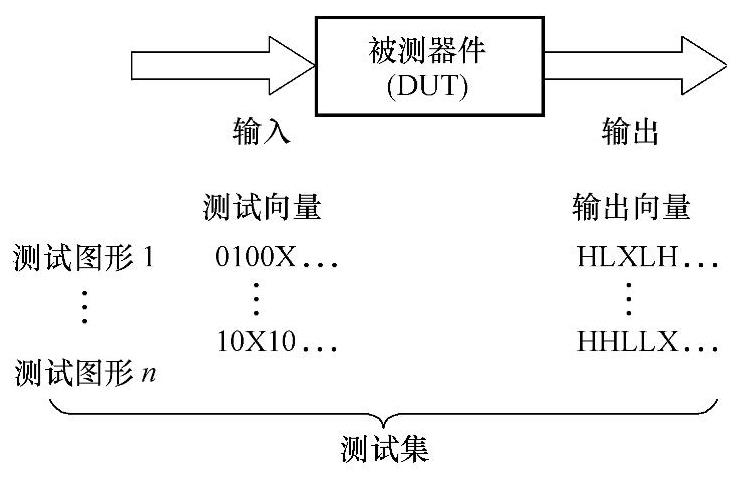
图11-5 数字集成电路测试原理
1)测试向量(vector)(或输入测试向量、输入向量):这是指以并行方式施加于被测器件初始输入端的逻辑0和1信号的组合,组合逻辑电路中,若输入变量数为n,则最多应有2n个测试向量。
测试码(code):能够检测出电路中某个故障的输入激励(测试向量),被称为该故障的测试码。
2)测试图形(pattern):输入测试向量和集成电路对输入测试向量的无故障输出响应合在一起称为测试图形。测试图形与测试向量一样,只是测量向量必须附加上该电路对输入测试向量的无故障输出响应。
3)测试集(set):故障测试集(简称测试集)是指一组测试向量或测试图形的集合。一般地讲,集合的原则是,一个测试集将确定被测电路是否有故障。一个测试集可以是穷举的、小于穷举的,或者是一个最小数,这要取决于测试图形产生算法。
3.故障及故障模型
对数字集成电路来说,最主要是测试其功能、时序关系和逻辑关系等。如果仅是测试一个集成电路是否存在故障,则称之为故障检测(fault detection)。不仅要检测集成电路中是否存在故障,而且要指出故障位置,进行故障定位(fault location),则称之为故障诊断(fault diagnosis)。故障检测和故障诊断统称为测试。
集成电路的不正常状态有:缺陷(defect)、故障(fault)和失效(failure)等。由于设计考虑不周全或制造过程中的一些物理、化学因素,使集成电路不符合技术条件而不能正常工作,称为集成电路存在缺陷。集成电路的缺陷导致它的功能发生变化,称为故障。故障可能使集成电路失效,也可能不失效;集成电路丧失了实施其特定规范要求的功能,称为集成电路失效。缺陷会引发故障,故障是表象,相对稳定,并且易于测试;缺陷相对隐蔽和微观,缺陷的查找与定位较难。
集成电路使用者一般不直接研究缺陷,仅研究故障。集成电路的开发和生产者肯定不能满足只研究故障,还需要找到具体的缺陷(设计或制造、物理或化学等)。
故障可以分为逻辑故障与非逻辑故障、永久性故障与间歇性故障、固定值故障与可变化值故障、硬故障与软故障等。
数字集成电路的故障模型可以分为逻辑门层次的故障模型、晶体管层次的故障模型和功能模块层次的故障模型。逻辑门层次的故障模型不能描述电路在晶体管层次的全部故障;晶体管层次的故障模型更能准确描述各种物理缺陷的电路行为和故障特征,但增加了测试的复杂性;功能模块层次的故障模型描述它是否能实施规范要求功能,适用于大规模集成电路的测试。
故障模型有两个基本要求:首先,模型必须精确,即电路中实际可能出现的物理缺陷应该尽可能被模型表述;其次,模型应尽可能简单,以便各种运算和处理较容易,能方便地用于大规模复杂集成电路系统。
4.数字集成电路测试的基本方法(https://www.xing528.com)
作为一个实例,首先考虑图11-6所示64位加法器的测试,它是只包含组合逻辑的简单网络(没有锁存器或其他双稳电路)。n位二进制输入,穷举测试时需2n个测试向量,即2n个穷举输入测试集,其输出响应必须依这2n个输入向量逐个进行检测,并需并行地检测与该测试向量对应的m个输出响应。
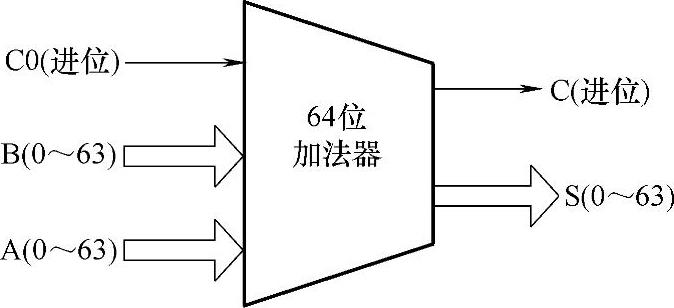
图11-6 只包含逻辑门的简单组合 电路测试(64位加法器)
一般说来,数字集成电路采用穷举测试是不现实的,若对图11-6的64位加法器进行穷举功能测试,全部输入/输出测试集共有129位输入,65位输出,穷举法将产生2129≈6.8×1038个测试向量,若用测试速率为1GHz的ATE进行测试,则需要2.15×1022年测试时间。所以,实际进行测试时只能用有限的功能测试集(典型最多覆盖70%~75%的故障)。
数字集成电路测试输出响应的检测有两种方法:①比较法,将被测器件与一个已知的好器件(称为“金器件”)进行比较的办法,称为比较法,如图11-7a所示。这种方法一般适用于比较简单的标准中、小规模集成电路等。②存储法,通过程序生成所需的测试集并存储于高速缓冲存储器(称图形发生器)。测试时,随测试主频率逐条读出,将该测试集的测试向量施加于输入端,并以测试集的输出图形部分(称预期图形)为标准,逐拍与被测器件输出的响应进行比较。由于这个方法涉及大量测试数据的存储和读出,常称为存储法,如图11-7b所示。该方法的优点是不需要标准器件,适用于复杂的器件及专用器件。

图11-7 输出响应的检测方法
a)被测器件与金器件比较 b)被测器件与预期输出图形比较
5.数字集成电路的测试内容
典型数字集成电路测试项目及其顺序如图11-8所示。
(1)接触测试(Contact Test)
接触测试又称开路/短路(O/S)测试,是指将DUT的电源和地接地,然后在DUT的每一个引脚上都施加一电流,测量其相应电压,如果所测得电压值超出了特定的电压值(如输入钳位电压等),则可认为引脚与测试仪的接触是断开的,即开路。如果所测得电压值小于特定的电压值,则可认为引脚与地存在短路故障。
接触测试可保证所测参数的正确性,消除由于内部引脚断线、接触不良、短路等造成的影响。
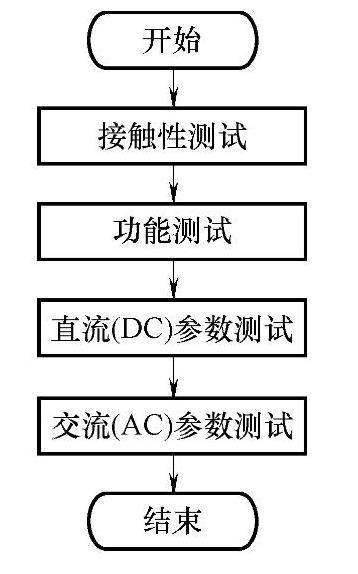
图11-8 典型数字集成电路测试项目及其顺序
(2)功能测试
功能测试用于验证器件是否能完成设计所预期的功能。功能测试包括静态测试和动态测试。静态功能测试通常按照真值表进行测试,动态功能测试是检测器件在高速工作时是否能完成预期功能的一种测试。
只有逻辑功能正确的电路,其后的参数测试才有意义。
(3)直流参数测试
直流参数测试是在DUT引脚上进行静态下的电压和电流测试。器件通过了直流参数测试,就可基本保证其电气性能。
(4)交流参数测试
数字IC的交流参数主要是与时间有关的参数,包括建立时间、传输延迟及上升时间、下降时间等。数字集成电路测试系统的时间测量单元TMU提供可选择的数字测时分辨力(从数ns到10ps),可测出数字IC的交流参数。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




