在FRD、快速晶闸管、RB-GTO[39,48]、RC-GCT[49]及PT-IGBT等器件中,都需要进行少子寿命控制。
1.快恢复二极管的双质子辐照
在高压二极管中,为了获得快速的反向恢复特性,常用电子辐照对其中的少子寿命进行控制。由于电子辐照得到的是均匀的少子寿命,不利于改善反向恢复特性和正向导通特性之间关系。所以,高压FRD一般采用双质子辐照控制其中的少子寿命,以获得较低的正向压降和快速的反向恢复特性。
图8-28所示为采用双质子辐照控制的SPT+(是在SPT结构的基础上通过元胞优化来获得发射极侧的高载流子浓度)型结构中少子寿命及载流子浓度分布[50]。可见,从阳极和阴极两侧分别进行少子寿命控制,于是在p+阳极区内形成了第一个缺陷峰,在靠近n缓冲层的n-区内形成了第二个缺陷峰(见图8-28b),导致这两处形成局部的低寿命区(见图8-28a),而n-中间区域的寿命保持不变,这样中间区域的高寿命可以保证低的正向压降,两侧的低寿命可以改善反向恢复特性。
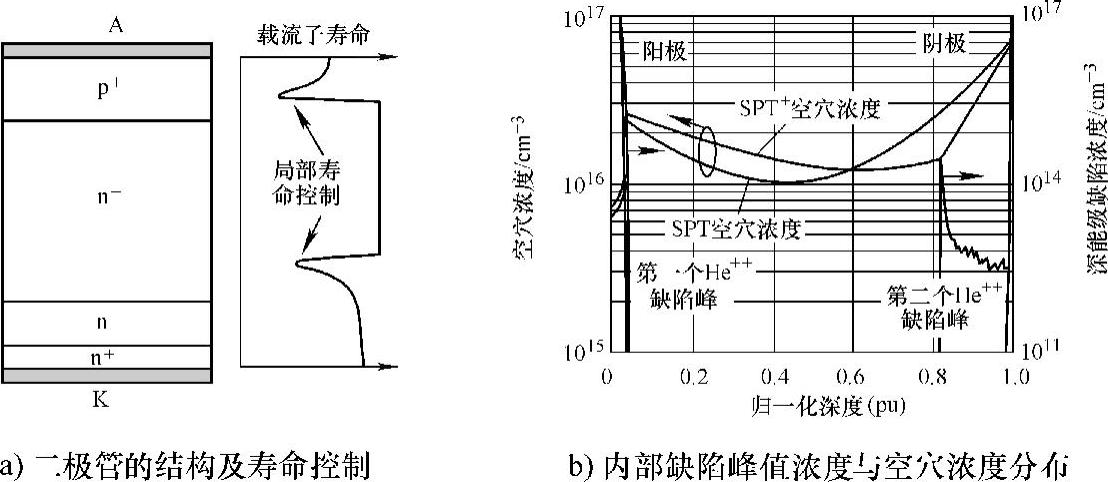
图8-28 快恢复二极管的结构及寿命分布和载流子浓度分布
与常规的SPT二极管特性相比较,采用双质子辐照形成的SPT+二极管的正向压降明显较低,并具有正温度系数,其反向恢复损耗与正向压降折中曲线也明显改善。此外,He++辐照退火后在二极管中会形成不同能级的电子陷阱和空穴陷阱,可分别用于控制电子寿命与空穴寿命,从而降低二极管的损耗和反向恢复峰值电压[51]。所以,通过控制陷阱的类型、能级及浓度,可在反向恢复时间、反向恢复峰值电流及正向压降之间取得很好的折中选择。
2.IGBT质子辐照
图8-29给出了一种内部透明集电极IGBT(ITC-IGBT)[52]与传统的PT-IG-BT结构。可见,在ITC-IGBT集电区内靠近n缓冲层的p+n结处有一载流子低寿命控制区,其厚度为0.5μm,是由He++辐照后(能量为370keV、剂量为4×1016 cm-2)在700℃下退火60min形成的。而PT-IGBT是采用电子辐照,其他工艺则完全相同。特性测试表明,ITC-IGBT在室温下和高温下与I-U曲线的交点[即零温度系数(ZTC)点]对应的电流密度约为80A/cm2,远低于额定电流密度(约150~200A/cm2)。而采用电子辐照的PT-IGBT的ZTC点对应的电流密度约为180A/cm2。所以,采用局部寿命控制的ITC-IGBT在饱和电压和关断时间之间获得更好的折中。
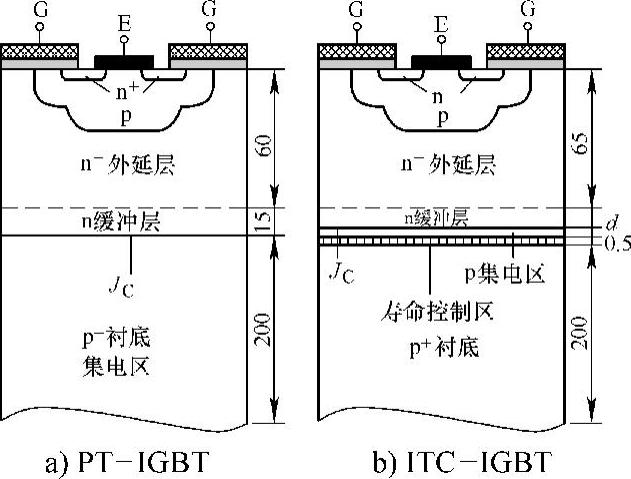
图8-29 ITC-IGBT中的少数载流子寿命控制
3.IEGT质子辐照
图8-30a所示为IEGT中质子辐照的缺陷位置及寿命分布。可见,采用质子辐照来控制IEGT中的少子寿命时,质子从集电极一侧射入,并终止在靠近n缓冲层处的n-漂移区内形成缺陷峰,导致此处寿命最低,并在n缓冲层和p+集电区处形成低浓度的缺陷拖尾。于是IEGT中载流子寿命为局部的非均匀分布。图8-30b给出了不同的少子寿命分布对IEGT通态I-U特性曲线[53]。可见,采用电子辐照的IEGT,其ZTC点对应的集电极电流约为1500A,采用质子辐照的IEGT,与其ZTC点对应的集电极电流降到500A左右。这说明采用质子辐照可改善器件的高温导通特性,使饱和电压在额定电流下为正的温度系数,有利于提高器件的高温稳定性。

图8-30 IEGT的质子辐照产生的少子寿命分布及其对通态I-U特性的影响(https://www.xing528.com)
4.RC-GCT的局部电子辐照
在RC-GCT中,由于非对称GCT采用了透明阳极,不需要进行寿命控制,但与之反并联的集成二极管必须进行少子寿命控制,才能在无吸收和高di/dt下实现关断。图8-31所示为RC-GCT的局部电子辐照方法及配件示意图[54]。如图8-31a所示,在实际的电子辐照时,为了避免非对称GCT部分(位于芯片外围)被照射,可采用图8-31b所示铅压块(或钼压块)来保护非对称GCT。为了减缓辅照区的深阱效应,铅压块采用了锥形口,并用图8-31c所示的铝合金垫块垫在芯片下起支撑作用,以免芯片因受铅压块的不均匀应力而破裂,其尺寸同芯片相匹配。

图8-31 RC-GCT的电子辐照方法及配件示意图
5.特殊用法
(1)利用复合控制技术形成隐埋的p-区 在快恢复二极管中,将He++辐照与Pd扩散相结合,不仅可以控制局部的少子寿命,而且可以在阳极侧处形成一个隐埋的p-区,能有效抑制二极管反向恢复时的动态雪崩,并获得更好的导通特性和阻断特性,以及低关断功耗。这种采用He++辐照与Pd扩散复合技术形成的二极管也被称为辐照增强扩散(Radiation Enhanced Diffusion,RED)二极管[56],因为通过He++辐照增强了Pd扩散。
p+pnn+二极管阳极面经He++辐照后,在725℃高温下进行Pd扩散,然后在350~700℃下退火,于是在阳极缺陷处形成一个隐埋的p-区,使二极管变成p+pp-nn+结构(见图8-32a)[55],由此导致二极管的峰值电场降低,其位置也发生变化,在反向恢复末期阴极侧的载流子浓度较高,故可以获得较大的软度因子。由图8-32b可知,采用标准He++辐照(能量11MeV、剂量为1×1011~2.5×1011 cm-2)的二极管容易发生动态雪崩,而采用He++辐照与Pd扩散复合技术的二极管在反向恢复期间表现出较软的恢复特性。

图8-32 采用钯(Pd)扩散与He++辐照复合技术与标准的He++辐照技术的比较
(2)利用质子辐照技术制作n缓冲层 质子辐照技术可以获得局部的少子寿命控制,除了用于改善器件的导通特性和关断特性、提高可靠性外,还可用来制作IGBT的n缓冲层。参考文献[57]报道了利用质子辐照技术开发的一种PT-IGBT结构,它是在原始n-硅衬底上先通过扩散形成100μm厚的p集电区,然后进行质子辐照,通过退火将质子辐照区转换成施主区,于是在p集电区和n-漂移区之间形成了一个比n-漂移区掺杂浓度稍高的n缓冲层,如图8-33所示。采用这种方法制作的PT-IGBT,n-层厚度可根据耐压来确定,并与集电结在n-区的耗尽层有关,比常规PT-IGBT的n-漂移区厚约10μm。故具有更宽的SOA和类似于NPT-IGBT的短路承受能力,并且通态特性和关断特性的折中关系比NPT-IGBT的更好。只是因n-漂移区稍厚,导致关断拖尾时间稍长,因拖尾电流较小,其关断损耗仍然较小。

图8-33 质子辐照形成的n缓冲层掺杂浓度分布
值得一提的是,在RC-IGBT中,采用FS耐压结构的IGBT不需要控制寿命,但需要对其中集成的二极管进行横向寿命控制。采用质子辐照或H+注入在RC-IGBT限定的局部区域内进行寿命控制,可能需要厚胶或金属掩模来掩蔽。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




