功率MOSFET和IGBT是由多个元胞并联而成,各元胞在表面处的电位基本相同,虽然中心元胞之间不存在击穿现象,但芯片边缘处的元胞与n-外延层之间存在着高电压;同时由于元胞形成的pn结表面曲率半径小,导致边缘处的元胞表面存在高电场强度。因此,需要采用结终端技术来降低结终端区的局部高电场强度,以提高表面击穿电压。
1.普通MOS型器件的结终端结构
功率MOSFET常用场限环结终端结构。对于500V以上高压MOSFET,还可采用场板与场限环复合结终端结构,如图7-16所示。采用多晶硅和金属铝层双重场板,可以解决场板边缘介质击穿问题。多晶硅场板主要用来改善主结电场集中,铝场板可以提高场板边缘的击穿电压。同时,为了提高击穿电压,还采用了p+场限环(也称分压环)和n+截止环(也称为等位环)。后者可以有效防止耗尽区扩展,使漏源间电场在表面上均匀分布,避免局部集中;同时可以收集表面沾污的正离子,提高表面稳定性。这种结终端结构与有源区工艺完全兼容,可利用硅栅MOS工艺来实现,多晶硅场板可以与多晶硅栅同时制作,两个铝场板可以与铝电极同时制作,不需任何附加工艺。
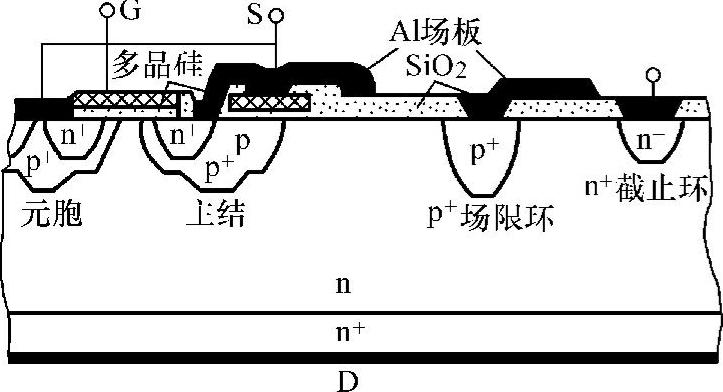
图7-16 功率MOSFET两级场板和场环结终端结构
与VDMOS结构相似,IGBT也是由许多元胞并联而成的(见图7-17)[4],也需要采用适当的场限环结构来降低其表面峰值电场强度。
2.超结MOS型器件的结终端结构
对于超结器件,由于p柱区和n柱区之间要保持电荷平衡,必须完全耗尽才能实现平坦的电场强度分布;同时有源区采用高掺杂浓度以获得低导通电阻,终端区采用较低的掺杂浓度以获得高耐压,使得柱区的掺杂浓度从有源区到终端区逐渐降低,于是横向电场强度变得不规则,降低了器件的可靠性。所以,终端设计需要同时考虑有源区和终端区的纵横向电场强度。
考虑到超结的制作工艺不同,结终端的结构也会不同。超结通常采用多次外延与刻槽回填工艺形成,因此超结器件的终端也可以分为延伸型与截断型[29]。
 (https://www.xing528.com)
(https://www.xing528.com)
图7-17 IGBT的中心元胞和外围元胞及耗尽区扩展宽度边界
如图7-18a所示[30],延伸型结终端结构是采用多次外延法将有源区外侧p柱与n柱的交替结构向外延伸到芯片边缘。与有源区的超结不同,终端的p柱区宽度更大些(比如由有源区的p柱区宽度为5μm,终端的p柱区宽度为10μm)。终端p柱区加宽,可以使全耗尽情况下净电荷为负;p柱的非均匀分布可以有效降低结终端区电场的扭曲[31],此外还可以使用多级场板。
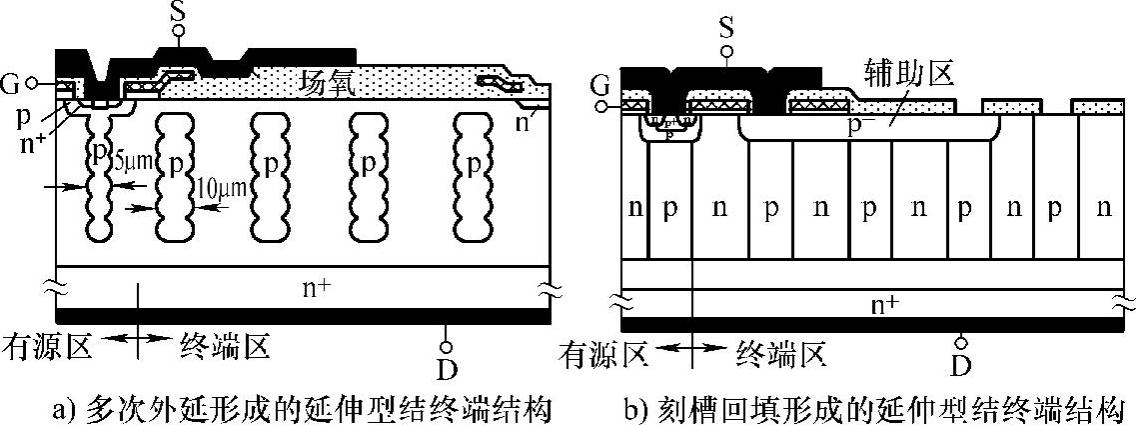
图7-18 超结MOSFET的两种延伸型结终端结构
如果采用刻槽回填法制造超结,也可以形成p柱、n柱交替出现的延伸型结终端结构。但在热氧化过程中,由于表面附近存在杂质分凝,会使p柱表面宽度变窄、n柱表面宽度变宽。当加上反压时,此处会提前击穿而形成热斑。为此,如图7-18b所示[32],可在表面注入一个p区,使n柱与p柱恢复平行,击穿电压得以提高[33]。
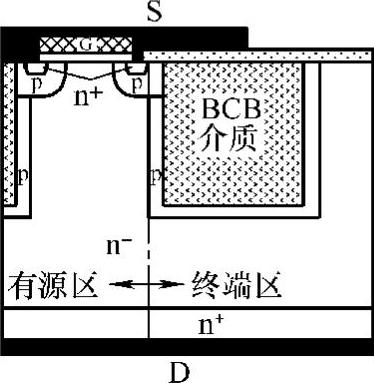
图7-19 超结MOS的截断型终端结构
图7-19所示的截断型结终端结构[34]是针对沟槽回填法形成超结器件设计的。2008年由H.Mahfoz Kotb等人提出的[35],是在n-外延层上先刻蚀好沟槽,再利用低压化学气相淀积(LPCVD)在槽内淀积一层重掺杂硼的多晶硅后进行高温扩散,于是在沟槽侧壁处形成了p柱区;最后在沟槽中填充低介电常数、高临界击穿电场强度的苯并环丁烯(BCB)介质。可见,终端的p区可以与有源区的p柱区同时形成,并且硼剂量可以精确控制,只是有源区的槽宽为5μm,结终端区沟槽宽约为70μm。此外,源极金属延伸到终端区深槽上方会形成场板。仿真结果显示,采用该结终端结构可以实现1300V以上的体击穿电压。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




