在功率集成电路中,常用的高压器件多数采用横向结构,使所有电极位于芯片表面,易于通过内部互连,实现与低压电路的集成。但由于横向器件的表面电场强度较高,为了获得优良的电学特性,并提高其稳定性,需采用各种电场调制技术,如降低表面电场(Reduced Surface Field,RESURF)技术和降低体内电场(Re-duced Bulk Field,REBULF)技术等。此外,为了解决SOI器件中存在较低的纵向耐压和严重的自加热效应等问题,电子科技大学研究组相继提出了“衬底终端技术”和“介质场增强(Enhanced Dielectric Layer Field,ENDIF)技术”,利用电场调制及屏蔽效应,通过对衬底和埋氧层的改造,达到降低体内电场强度和表面电场强度的作用。
1.降低表面电场技术
降低表面电场(RESURF)理论是1979年由J.A.Apells等人提出的[6]。RE-SURF技术是指在p型衬底上外延一薄层轻掺杂的n-区,使其在达到临界击穿电场强度之前全部耗尽,以承受大部分的外加电压,并降低表面峰值电场强度,使击穿点从表面pn转移到体内pn结,从而提高击穿电压。
采用RESURF技术,可使高压器件与低压电路通过结隔离集成在同一芯片上。引入LDMOS后,使其突破硅器件的理论极限,显著改善了器件的击穿电压与导通电阻。目前在Si-LDMOS和SOI-LDMOS中得到广泛使用。
图6-3给出了RESURF二极管击穿时的电场强度分布。如图6-3a所示,当n-外延层较厚时,表面纵向p+n-结的峰值电场强度Es达到临界电场强度Ecr(即Es=Ecr)时,n-外延层还没有耗尽,击穿发生在表面。如图6-3b所示,采用RESURF技术,当n-外延层较薄时,由于纵向p+n-结的耗尽层被横向p-n-结加强,在给定的反偏压下,沿表面有较长的扩展,故表面电场强度低于临界电场强度(即Es<Ecr)。如图6-3c所示,当外加电压进一步增加时,表面电场强度仍然低于临界电场强度(即Es<Ecr),但体内横向p-n-结的电场强度增加,等于临界电场强度(即Eb=Ecr),于是击穿电压由横向p-n-结决定,可达到理想的击穿值。

图6-3 RESURF二极管击穿时电场强度分布
对RESURF技术而言,为了提高击穿电压,要求严格控制外延层的电荷,使之满足以下电荷条件:
Nepidepi≈1×1012cm-2 (6-1)
式中,Nepi为外延层的掺杂浓度;depi为外延层的厚度。(https://www.xing528.com)
当满足此约束条件,可得到RESURF器件理想的击穿电压为
UBR=EcrLdrift (6-2)
式中,Ecr为外延层掺杂浓度所对应的临界击穿电场强度;Ldrift为n-外延层的长度。
如外延层的掺杂浓度和厚度不满足此约束条件,则任何外延层电荷的变化都会引起器件的击穿电压降低。所以,横向功率器件的设计几乎都以RESURF原理作为理论基础。
2.降低体内电场技术
对采用RESURF技术设计的nLDMOS,其中高电场主要集中在漏端,而源端电场较低,由此导致器件的外延层中存在着非均匀的电场强度分布。为了解决这一问题,电子科技大学(成都)段宝兴博士等提出了降低体内电场(Reduced BULk Field,REBULF)的概念[7]。REBULF技术是指在器件中引入了高掺杂浓度的埋层,使得漂移区的电场强度重新分配,更加均匀地分布在漂移区中,以提高器件的耐压。如图6-4所示,通过在p衬底内引入一层高掺杂浓度的n+埋层,使得电场强度在外延层和衬底中重新分配,于是外延层的电场强度分布得更均匀。同时由于高掺杂浓度n+埋层与p衬底之间形成了二极管,使得衬底的耐压也显著增强,从而提高了整个器件的耐压。
REUBLF原理也可以应用到SOI功率器件中,既可以调制SOI层中的电场强度,同时也可以增强埋氧层中的电场强度,因而提高了SOI器件的耐压。
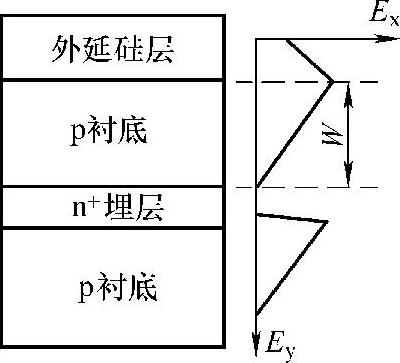
图6-4 REBULF原理示意图
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




