几十年来,半导体晶体管一直沿着摩尔定律所拟定的路线图不断发展[1],现在晶体管的特征尺寸已经达到了100nm以下的纳米级,如图22.1所示。2003年,第一种使用传统二氧化硅绝热材料和多晶硅栅极的带有90nm晶体管的逻辑器件产品大量投产。2007年,推出了尺寸为45nm的逻辑器件产品[2,3],这种产品中的晶体管采用了革命性的高介电常数金属栅极技术。这些纳米器件实现了性能更高的电路,这也相应地促进了先进特征在这些器件的封装中出现。这些器件能够显著地降低高性能逻辑产品的功耗(见图22.2),而这些高性能逻辑产品又在快速增长的微移动市场中创造新的应用,并因此需要封装能够满足这些器件的形状因素要求。本章将讨论这些纳米器件的倒装芯片封装所面临的挑战和机遇。

图22.1 特征尺寸和晶体管栅极长度变化[4]

图22.2 移动电话市场发展趋势(美国Prismark Partners有限责任公司提供)
在早期的半导体产业中,微电子封装主要提供空间转换功能,同时也为小而昂贵的集成电路器件提供结构和环境保护,这样集成电路器件就能连接到相对大的电子系统主板上。在过去的几十年里,微电子封装的功能已经扩展至逻辑器件的电性能管理和热性能管理,同时微电子封装也使电子系统小型化。在这次变革中,抑制封装的成本和满足环境规定等是关键的约束条件。
过去几年,电子封装技术进步显著。为了有效地描述电子封装技术的这些进步及其未来面临的挑战,在本章我们将主要探讨手提式电脑、台式电脑和服务器等计算系统中的逻辑集成电路,因为这些一般都需要先进的封装。而这些系统之所以需要先进的封装是由于其内部高性能微处理器。同时,我们也以手机等典型的超移动系统为例,描述了一些形状因数驱动的封装技术。
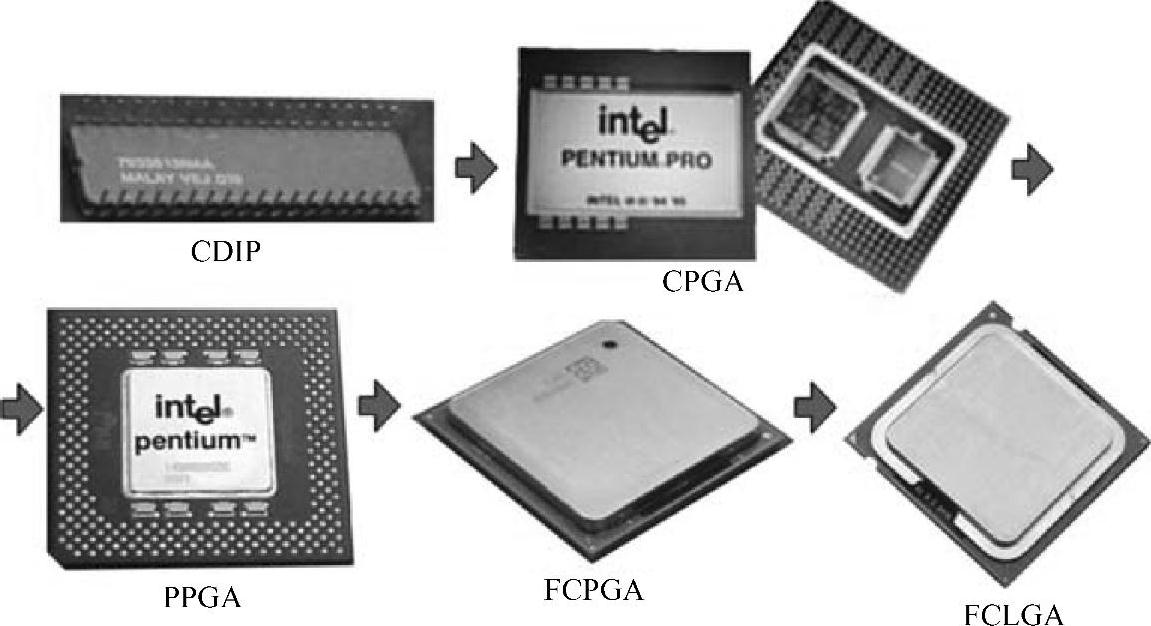
图22.3 台式个人电脑微处理器封装的演化过程
台式个人电脑封装的发展如图22.3所示。20世纪80年代初,8088处理器芯片采用了陶瓷双列直插式封装技术(Ceramic Dual In-line Package,CDIP)。在这种封装技术中,金属丝焊把硅芯片连接到陶瓷封装外壳的引脚上。陶瓷封装的面积为800mm2,共40个引脚,布置在它的两个长边上。因为8088处理器的运行频率只有5MHz,且其功率仅为1~3W,所以仅用不到10%的引脚便足以向芯片供电。剩下的引脚则用于微处理器信号的输入和输出。这种封装最主要的功能是提供空间变换和环境保护。
到1994年,高能奔腾处理器采用了陶瓷引脚网格阵列(Ceramic Pin Grad Array,CPGA)封装,封装含有387根引脚、一块大的铜钨合金散热片和两块芯片———CPU芯片和一个独立的静态随机存储器(SRAM)芯片。这种封装中,超过40%的引脚用于向芯片提供功率,这说明了封装的功率提供能力越来越重要。(https://www.xing528.com)
到20世纪90年代中期,陶瓷封装的成本和导体电阻促进了封装技术的重大改变。台式个人电脑的CPU封装改用塑料引脚网格阵列(Plastic Pin Grid Array,PP-GA)封装技术,这种封装不同于陶瓷引脚网格阵列封装。后者是把钨导体封装在陶瓷基板上,而它是把铜导体封装在有机基板上。在塑料引脚网格阵列封装技术中,焊线过程中要求互连焊盘必须放在裸片的边缘。长导线的自感和与长的片上互连的电阻降低了这种封装的功率传递能力。另外,在裸片边缘放置电源焊盘和信号焊盘限制了芯片的尺寸缩小能力。
在20世纪90年代,这些限制促进了其他一些重大技术的发展。至1999年,先进处理器,如奔腾Ⅲ,已经转向采用有机倒装芯片球栅阵列(Flip Chip Ball Grid Array,FCBGA)的封装技术[5,6],不久后又采用了倒装芯片引脚栅格阵列(Flip Chip Pin Grid Array,FCPGA)封装技术。由于在含有焊盘栅格阵列(LGA)的产品中存在易碎的封装引脚,2004年人们引入了倒装芯片焊盘栅格阵列(Flip Chip Land Grid Array,FCLGA)封装技术,以便消除这些易碎封装引脚。
另外,互连的改变、功耗和功率密度不均匀性的增加,已促使功率传递和热管理技术显著进步。图22.4详尽地描述了封装技术是如何按照摩尔定律驱动的产品要求同步发展的。
自然而然,超移动系统需要小型化的器件。结果,这些系统中的关键器件,如逻辑器件、存储器和无线器件,已经向小型化方向发展,以便在封装中提供更多的计算、通信和存储容量。图22.5给出了这些系统中关键封装的发展过程。在整个发展过程中,封装的水平尺寸一直在缩小。另外,人们已经在利用封装的垂直空间方面取得了很大进展,通过利用封装的垂直空间能有效地提高集成电路的容量密度。
材料技术在封装技术中扮演了很重要的角色。对封装的性能要求,如热管理能力、功率传递能力、信号完整性、结构的完整性、环境和制造上的考虑等,推动了材料技术的发展。随着半导体器件按照摩尔定律继续缩小和微移动系统器件的形状因数继续缩小,这种趋势还会继续。材料技术的进步也受到环境规章的影响。近几年,通过对有害材料的限制,人们对电子封装进行了改进设计,使之变得环保。这种新型环保封装的主要特征是它使用了无铅的封装材料和无卤族元素的基板技术,淘汰了溴化阻燃剂。通过不再在高性能微处理器封装[3,7]中使用铅,电子封装行业正在积极回应各项环保规章,并制定策略以便贯彻无卤封装。
在本章接下来的各节中,对于引言中讨论的倒装芯片封装技术,我们将更详细地论述其主要特性的发展趋势。

图22.4 封装技术是如何与硅和微处理器同步前进的
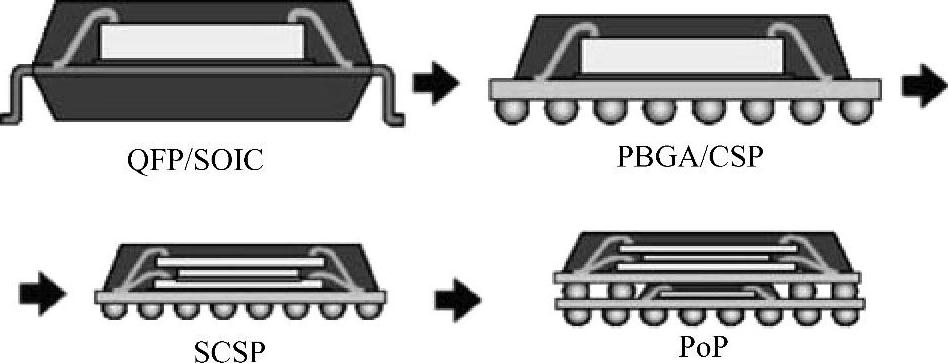
图22.5 超移动电子系统封装的革新
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




