直流光电导衰减法已作为测量少子寿命的标准方法。它的优点是测量准确度高,测量下限比高频光电导法低,可以测m几个微秒的寿命,在某些特别的装置中,还可以测到0.lp.s的寿命,而高频光电导法测量下限一般为20-30,u.s。光电导衰减法测量寿命的下限,主要受到脉冲光余辉的限制。除余辉外,还要求光源的波长在可见光或近红外波长范围,这样可以保证有较高的贯穿深度,并能将满带中的电子激发到导带,在样品内产生非平衡载流子。可测的最低寿命标准为10,u.s,取决于光源的余辉;可测的最高寿命主要取决于试样的尺寸。表11-8列出可测的最高寿命。
表11-8 可测的最高寿命

1.原理 直流光电导衰减法也称为脉冲光法。此方法不破坏试样的内在特性,试样可以重复测试,但要求试样有特殊的条形尺寸和研磨表面。在两端面为研磨表面并具有欧姆接触的单一导电类型的半导体单晶试样上,通一直流电流,用示波器观察试样上的电压降。对试样加一脉冲光,在试样上产生非平衡少数载流子,同时触发示波器扫描。从脉冲光停止起,电压衰减的时间常数可由示波器扫描测得。当试样中电导率调幅非常小时,所观察到的电压衰减等价于光生载流子的衰减,因此电压衰减的时间常数就等于非平衡少数载流子衰减的时间常数,少数载流子寿命即由该时间常数确定,用公式(11-37)表示。必要时应消除陷阱效应,对表面复合及过量电导率调幅进行修正。
ΔV=ΔV0exp(-t/τF) (11-37)
式中 ΔV———光电导电压(V);
ΔV0———光电导电压的峰值或初值(V);
t———时间(μs);
τF———表观寿命(μs)。
直流光电导衰减法不适合于抛光片的验收测试;不适用于测试条件下呈非指数规律变化信号的试样。
2.表观寿命与体寿命
(1)表观寿命。光电导衰减到初始值的1/e时的时间常数τF(μs)。
(2)体寿命。晶体中非平衡载流子由产生到复合存在的平均时间间隔,它等于非平衡载流子浓度衰减到初始值的1/e时,所需要的时间,又称少数载流子寿命。
3.测量仪器
(1)测试电路图见图11-17。直流光电导衰减法测量少子寿命电路系统,主要有光学和电学两部分。光学部分包括光源、光学系统、滤光片等。光学部分可给出一个具有很短切断时间的光脉冲,并有合适的光强度和波长。电学部分包括电压表、直流电源、串联电阻、前置放大器,以及用以显示波形的示波器等。直流源用干电池或交流整流电源均可。

图11-17 直流光电导衰减法测量少子寿命电路
(2)电源。电源应稳定并经过良好过滤,应在试样上产生不低于5V的直流电压,RL为回路中的外加串联电阻,RL值至少是试样电阻R及接触电阻Rc之和的20倍。它的作用是保证回路是恒流的,使回路电流不受电阻改变的影响,为了测量不同的样品,还要求直流电源和电阻RL是可调的。电路中还应有对试样电流换向及切断试样电流的开关装置。
直流电源在样品中产生的电场强度的大小应满足如下的不等式:

式中 τ———样品少子寿命(μs);
μ———少子迁移率(cm2/V·s)。
样品应装在一个金属盒子中,以屏蔽外电场。样品仅在中心占1/2总长的部分受光照射,两端要遮住。图11-18是图11-17的等效电路,这个电路是恒流电路,电流的大小为I,电阻为

式中 ρ———电阻率(Ω·cm);
l———长度(cm);
A———截面积(cm2)。
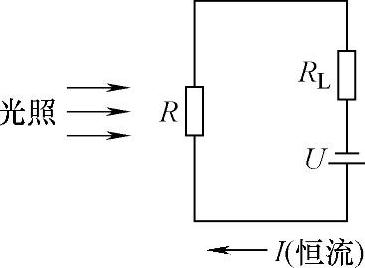
图11-18 等效电路
样品上无光照时,样品中没有非平衡载流子,样品两端的电压为
U=IR
若给样品进行光照,样品中就产生了非平衡载流子,引起了样品电导率的增加,电阻下降。假设样品电阻的变化量为ΔR,那么样品两端的电压变化量ΔU为
ΔU=IΔR
ΔU与非平衡载流子之间的关系为

设样品在没有光照时的电导率为σ0,光照后的电导率为σ,则电阻率的变化量Δρ为

所以

假设光照不太强,这时注入半导体中的非平衡载流子较少,因此样品电导率的变化很小,也就是说满足小注入条件。这时
σ≈σ0Δσ/σ0﹤﹤1
式(11-40)就成为

对n型样品来说
σ0=n0eμn
Δσ=qΔp(μp+μn) (11-42)
式中 q———电子电荷量;
Δp———光激发时的非平衡载流子的浓度;
μp———空穴迁移率;
μn———电子迁移率。
将式(11-42)代入式(11-41),得

最后得到

其中
对于P型样品,可得

由式(11-44)可知,样品两端电压的变化量与半导体中非平衡载流子浓度成正比关系,因此非平衡载流子的变化情况可以用电压的变化情况来表示。测量出样品两端电压衰减规律,就能正确地反应出非平衡载流子的衰减规律。但是应注意,上述测量原理只在小注入的条件下才能成立。
(3)光源。脉冲光源应在光强从最大值减少到其10%时关断,或关断时间小于所测试样寿命时间的1/5或更少。用于硅试样测量的光源光谱分布的最大值应在波长范围1.0~1.1μm以内。氙光管或放电管,配备0.01μF的电容器,可提供频率为2~60Hz脉冲的高压电源。光源应在0.3μs内达到最大光强,并在小于0.5μs内光强由最大值下降不大于5%。采用更小的电容可获得更短的脉冲宽度,适合测量表观寿命低于5μs的试样。
(4)试样夹具及恒温器。隔热试样夹具及恒温器应使试样处于规定温度27℃±1℃;夹具与试样的整个端面应保持欧姆接触,并至少应使试样四个侧面中的一个侧面处于光照下。
制作与试样端面成欧姆接触的试样夹具的方法较多,建议使用金属带或纤维的压力接触,也可用厚铅板和铟板。
(5)滤光片。它由与试样相同的材料制成,厚度为1mm,应双面抛光,直接放置在矩形窗孔膜片的上方。
(6)矩形窗孔膜片。将它放置于靠近试样的光照表面,光透过矩形窗孔膜片,只能照射到试样的部分区域。光照区域的长度Li=L/2,宽度Wi=W/2;光照部位都在试样中央位置。
(7)电信号测量线路
1)前置放大器具有可调的高、低频频带范围。低频截止频率从0.3~30Hz可调。
2)示波器具有适合的时间扫描、信号灵敏度及经校准的时间基线;其精度和线性度都优于3%,并能被试验信号或外部信号触发;还应配备有助于分析衰减曲线的透明屏幕,规定屏幕尺寸在10cm×10cm以内,该尺寸有利于减少视差。示波器屏幕上刻有一条曲线,在基线上方的高度沿横坐标的距离呈指数衰减(见图11-19),指数曲线的方程式为
y=6exp(-x/2.5) (11-45)
x、y的刻线都是以刻度盘的刻度划分。
3)对总体线路要求
① 校正垂直扫描灵敏度至0.1mV/cm或更低。
② 校正垂直增益和扫描线性度在3%以内。
③ 响应时间。输入信号以步进方式变化时,输出信号的衰减不超过所测量最小表观寿命值的1/5。(https://www.xing528.com)
④ 脉冲没有明显变坏现象,例如无过冲或阻尼效应。
4.样品制备
(1)试剂和材料
1)纯水25℃时,电阻率大于2MΩ·cm的去离子水。
2)研磨材料为氧化铝粉,颗粒范围为5~12μm。
(2)取样。从晶体上指定区域切取试样,长度为L、厚度为T、宽度为W见表11-9。

图11-19 示波器屏幕上的指数曲线
表11-9试样尺寸(单位:mm)

记录所有尺寸,精确到0.1mm。较低寿命值的材料测量宜使用较小尺寸的试样。直接单晶硅的测量大多使用类型B,而区熔单晶硅的测量建议采用类型C。
(3)研磨。测量前,用氧化铝粉研磨试样,使试样的6个表面成为平整的磨面。
(4)清洗。将研磨后的试样用超声波清洗或用水冲洗,用干燥氮气吹干,试样端面应清洁干净,有利形成良好的欧姆接触。
(5)欧姆接触材料。在试样端面应形成欧姆接触,可使用镍、铑或金电镀浴,要避免铜沾污。对硅试样,可用一小滴镓滴在金刚砂布上,研磨端面,并使用加热盘将试样加热至35℃。
(6)欧姆接触。在试样两个整端面上制作欧姆接触。对硅试样加热到35℃,研磨端面,防止滴在金刚砂布上的镓形成镓污点。也可在n型硅试样端面镀镍,在p型硅试样端面镀铑。
(7)测试接触点。将试样置于夹具中,以一个方向接通电流,在试样上形成2~5V的电压,记录该电压降V1。改变电流方向,记录试样上的电压降V2。如果V1与V2的差小于5%,则试样具有欧姆接触。
5.测量步骤
(1)用试样夹具夹紧试样,定位于膜片的矩形窗孔处,使试样的中央处于光照下。测量并记录试样夹具的温度,取值±1℃。
(2)开启光源,将前置放大器与示波器接通。
(3)接通电源,调整电流,在试样上产生2~5V。
(4)使观察到的衰减曲线与画在示波器透明屏上的标准指数曲线一致(见图11-19的指数曲线)。方法如下:
1)调节垂直位移旋钮,使观察到的衰减曲线的基线与标准指数曲线的基线重合。将时间基准扫描速度调到较低值,使屏幕横向上出现多个衰减曲线,以易于调节。
2)延长时间基准以产生一个单周期信号图样;调节水平位移、垂直放大和时间基准扫描速度,直到观察到的曲线与标准指数曲线尽可能吻合,脉冲峰值ΔV0与标准曲线左边上方点一致。
(5)测试试样是否存在光生伏特效应。关断电流,保留光照,其他旋钮不动,观察示波器是否检测到一个光电压信号。如果检测到一个超过脉冲峰值1%的信号,则试样中存在光生伏特效应,此试样不适合用本方法测量。
若没有观察到上述光电压信号,且衰减曲线呈指数曲线,则可由下式确定表观寿命τF(μs):
τF=2.5S1 (11-46)
式中 S1———时间基准扫描速度(cm/μs)。
6.计算
(1)小注入条件下的体少数载流子寿命计算如下:
τB=(τF-1-RSF)-1 (11-47)
式中 τB———体少数载流子寿命(μs);
τF———表观寿命(μs);
RSF———表面复合率(μs-1),标准样品的RSF查表11-10。
(2)对长条形试样,表面复合率RSF计算如下:
RSF=π2D(L-2+W-2+T-2) (11-48)
式中 L、W、T———试样的长、宽、厚(cm);
D———少数载流子扩散系数(cm2/s),电子扩散系数Dn=36cm2/s,空穴扩散
系数Dp=13cm2/s。
(3)对圆柱形试样,表面复合率RSF计算如下:
RSF=π2D(L-2+9/16r2)(11-49)
式中 L、r———试样的长度、半径(cm);
D———少数载流子扩散系数(cm2/s),电子扩散系数Dn=36cm2/s,空穴扩散系数
Dp=13cm2/s。
7.格数计算法 在直流光电导衰减法中,样品两端的电压衰减信号取出之后,通过前置放大器的放大,再输入到脉冲示波器观察;在指数衰减曲线上,找出当信号从初始值到衰减至初始值的1/e倍的时间,把这一时间确定为非平衡载流子的寿命。图11-20示出指数衰减曲线。通过观察测试系统中的示波器的荧光屏上被显示出的指数衰减曲线,然后计算出少数载流子寿命值。

图11-20 指数衰减曲线
假设示波器的荧光屏上被显示出的最大信号为n格(1格为1cm)时,从荧光屏上显示出的指数衰减曲线可读出是4格,在指数衰减曲线是取得 ,例如
,例如 ,然后在x轴上查找出对应的格数,图中为2.4格。如果水平扫描时间设定为100μs/格,将格数乘扫描时间即为其少子寿命。即少子寿命τ为
,然后在x轴上查找出对应的格数,图中为2.4格。如果水平扫描时间设定为100μs/格,将格数乘扫描时间即为其少子寿命。即少子寿命τ为
τ=2.4格×100μs/格=240μs
8.干扰因素
(1)陷阱效应影响。室温下的硅,载流子陷阱会产生影响。如果试样中存在电子或空穴陷阱,脉冲光停止后,非平衡少数载流子将保持较高浓度,并维持相当长一段时间,光电导衰减曲线会出现一条长长的尾巴。在这条衰减曲线上进行测量,将错误地导致寿命值增大。
1)沿衰减曲线进一步延伸,由衰减曲线高端至低端进行测量,若时间常数增加,可判定存在陷阱效应。把试样加热到50~70℃,或用一稳定的本底光照射试样,可消除陷阱效应。
2)当试样中陷阱效应超过衰减曲线总幅度的5%,就不能用本方法测量少数载流子寿命。
(2)表面复合率影响
1)表面复合率会影响测量寿命,特别是使用小块试样时。表11-10列出试样尺寸对应的表面复合率RSF。
表11-10试样尺寸对应的表面复合率RSF

在前面“6.计算”中,给出了表面复合修正的一般公式,即式(11-48)和式(11-49)。当试样表面积与试样体积之比很大时,更有必要进行修正。
2)若对表面复合修正太大,会严重降低测量的准确性。建议对测量值的修正不要超过测量值倒数的1/2,即表观寿命需大于体寿命的一半,或表面复合率不大于体寿命的倒数。标准条形试样所测定的最高体寿命值列于表11-8。
(3)注入量的影响。测量时试样电导率调幅必须很小,这样试样上的电势差的衰减才等价于光生载流子的衰减。当试样上最大直流电压调幅ΔV0/ΔVoc(初始电压增量/开路电压增量)超过0.01时,允许进行修正。
(4)光生伏特效应影响。试样电阻率不均匀会产生使衰减信号扭曲的光电压-光生伏特效应。在没有电流通过时,就呈现光电压的试样不适合用本方法测量。测量时避免光照。
(5)光源波长的影响。光生载流子大幅度衰减会影响曲线的形状,尤其是在衰减初期使用脉冲光时,这种现象更为显著。因为脉冲光源注入的载流子初始浓度一致性差,要求使用滤光片以增加注入载流子浓度的一致性,并在衰减曲线峰值逐渐减弱后进行测量,或用单色激光作光源。
(6)电场影响。如果少数载流子被电流产生的电场扫出试样的一端,少数载流子就不会形成衰减曲线。因此需要一块挡光板遮挡试样端面,使测试中扫出效果不显著。
样品内的电场强度对直流光电导衰减法测量少子寿命有很大影响。在光照激发出非平衡载流子后,非平衡载流子会在体内逐渐复合掉。但是,若样品内的电场强度太大,直流电场也会对非平衡载流子产生作用,使它以很高的速度漂移,使得部分少数载流子尚未来得及复合,就被电场牵引出半导体外,显然这样测量得到的样品少子寿命值偏低。为此,提出了“临界电场”的概念。临界电场就是非平衡载流子扩散运动和漂移运动速度一致时的电场强度。

式中 Eint———临界电场强度;
μ———电子或空穴迁移率;
τ———非平衡载流子寿命。
只要半导体内的电场强度在临界电场以下,就不会影响到测量的准确性。
(7)温度影响。半导体中杂质的复合特性受温度强烈影响,控制测量时的温度就相当重要。在相同温度下进行的测量才可以进行比较。
(8)杂质复合中心的影响。不同的杂质复合中心,具有不同的复合特性。当试样中存在一种以上类型的杂质复合中心时,观察到的衰减曲线可能包含两个或多个具有不同时间常数的指数曲线,诸曲线合成结果也不呈指数规律,测量不能得出单一寿命值。
(9)滤光片的影响。滤光片本身有信号,它和试样信号叠加产生测试误差。因此应选择厚度1mm、与被测试样材料相同、信号较弱(低寿命值)的滤光片。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




