因为辐射损伤会严重影响半导体的电性能,因此通常在一定条件下对离子注入后的靶片进行热处理,即退火,以消除辐射损伤所造成的缺陷,让被损伤的晶格得到恢复。另外,通过离子注入的杂质原子往往位于晶格间隙处,而在半导体中处在间隙处的杂质原子是没有载流子贡献的。也就是说只有通过热处理使其处于晶体点阵位置,才能成为施主或受主。因此退火除了消除晶格缺陷外还要激活注入杂质原子的活性,从而起着双重作用。
目前在实际生产中使用较为普遍的退火方式是快速退火,将离子注入后的硅单晶片置入石英管内进行加热退火,时间从数十分钟到几小时不等。退火时一般处在真空或保护气氛下,根据工艺的不同保护气氛可以是N2,Ar,O2或H2等。合理的退火工艺的选择对器件的性能是至关重要的,不同的掺杂离子,不同的掺杂剂量和注入时的温度对所要求的退火工艺不同。图7-35给出了不同的注入离子注入Si中薄层载流子浓度和退火温度的关系和不同注入剂量P在〈110〉Si中注入时载流子浓度和退火温度的关系。从图7-35(a)中可见,对于P和As注入,在600℃退火时就能达到要求而对于B注入来讲,当退火温度达到900℃时薄层载流子浓度才能达到相应值。表7-4给出了在一般情况下Si中离子注入不同的退火温度所能实现的目标。
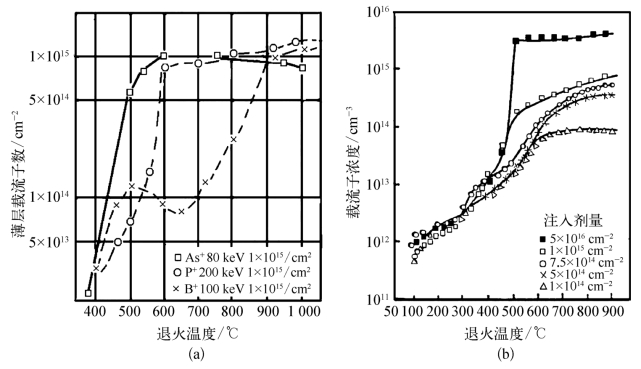
图7-35 不同注入离子和注入剂量在Si中载流子浓度和退火温度关系
(a)薄层载流子浓度和退火温度关系(b)p+在〈111〉Si中沟道注入等时退火
表7-4 硅注入在不同退火温度下所达到的目标(https://www.xing528.com)

在退火过程中,虽然离子注入引入的大部分缺陷可以被消除,但还会有部分缺陷残留下来并结合成较大的缺陷,这些缺陷被称为二次缺陷。表7-5显示了在不同的退火温度下透射电子显微镜所观察到的二次缺陷。常见的二次缺陷有黑点、各种位错环、杆状缺陷、层错以及位错网等。二次缺陷可以影响注入原子在晶体中的位置,载流子的迁移率和少数载流子的寿命等。在实际运用中应采取合理的注入工艺和退火工艺来减少二次缺陷的种类和数量。
表7-5 不同注入温度和退火温度下所观察到的二次缺陷

在退火工艺中除了常用的管式炉加热退火外,目前可以运用到离子注入进行退火的方法还有激光退火、电子束退火和红外退火等。激光退火又可分为脉冲激光退火和连续激光退火。通常来讲激光退火与常规退火相比有三个主要的优点。其一是激光退火后样品中注入杂质的电激活率、少数载流子扩散长度等电特性比热退火要优;其二是激光退火能使注入层的辐射损伤得到充分消除;其三由于激光退火所需时间十分短暂,因此在退火过程中杂质分布不会发生变化,同时利用细微激光束可进行局部选择性退火。电子束退火与激光退火相比其优点是束斑均匀性比较好,能量转换率高。红外退火是利用红外辐射,由硅中自由载流子吸收红外辐射而使硅片迅速加热,在5~10 s内可使硅片达到退火温度。在红外退火过程中因时间很短,杂质扩散小,有利于浅结的制备。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




