刻蚀设备的发展和光刻技术、互联技术密切相关。high-k/low-k材料,铜互联,Metal Gate等技术的发展都对刻蚀设备提出了新的需求。在200 mm晶圆时代,介质、多晶以及金属刻蚀是刻蚀设备的三大块。进入300 mm时代以后,随着铜互联的发展,金属刻蚀逐渐萎缩,介质刻蚀份额逐渐加大。介质刻蚀设备的份额已经超过50%。而且随着器件互联层数增多,介质刻蚀设备使用量就越大。AMAT、Lam两大公司占据了绝大部分刻蚀设备市场。
最常见的刻蚀设备是使用平行板电极的反应器。早期的桶式刻蚀设备,则是将电极加在腔外,适合应用在等向性的刻蚀(如光刻胶的去除)。为了提高等离子体的浓度,在反应离子刻蚀机RIE中,加上磁场而成磁场强化活性离子刻蚀机(magnetic-enhanced reactive ion etcher,MERIE)。另外,还有一部分刻蚀机改变激发等离子体的方式,并在低压下操作,这类刻蚀机被称为高密度等离子体刻蚀机。它具有高等离子体密度和低离子轰击损伤等优点,已成为设备开发研究的热点,典型的设备有电子回旋共振式等离子体刻蚀机(electron cyclotron resonance plasma etchers,ECRPE)、变压耦合式等离子体刻蚀机(transformer coupled plasma,TCP)、感应耦合等离子体刻蚀机(inductively coupledplasma reactor,ICPR)和螺旋波等离子体刻蚀机。在本节中,具体介绍现今较为常用的刻蚀设备。
1.反应离子刻蚀机(RIE)
RIE包含了一个高真空的反应腔,压力范围通常在1~100 Pa,腔内有两个平行板状的电极。如图6-6(a)所示,其中,一个电极与反应器的腔壁一起接地,另一个电极与晶片夹具接在RF产生器上(常用频率为13.56 MHz)。当接通RF电源时,等离子体电位通常高于接地端。因此,即使将晶片放置于接地的电极上,也会受到离子的轰击,但此离子能量(0~100 eV)远小于将晶片放置于接RF端的电极时的能量(100~1000 eV)。将晶片置于接地端的方式称为等离子体刻蚀,而将晶片置于RF端的方式称为活性离子刻蚀,刻蚀通常是以RIE模式来完成。在这一设备中,除了利用原子团与薄膜反应外,还可利用高能量的离子轰击薄膜表面去除二次淀积的反应产物或聚合物,从而达成各向异性的刻蚀。传统RIE的优点是结构简单且价格低廉。其缺点是在增加等离子体密度的同时加大了离子轰击的能量,这会破坏薄膜和衬底材料的结构。另外,当刻蚀尺寸小于0.6μm之后,刻蚀图形的深宽比将变得很大,需要较低的压力以提供离子较长的自由路径,确保刻蚀的垂直度。而在较低的压力下,等离子体密度将大幅降低,使刻蚀效率变慢。解决离子能量随等离子体密度增加的方法是改用三极式RIE,如图6-6(b)所示。它有三个电极,可将等离子体的产生与离子的加速分开控制,进而达到增加等离子体密度而不增加离子轰击能量的需求。而要解决低压时等离子体密度不足的现象,则要靠后述的高密度等离子体来完成,亦即需改变整个等离子体源的设计。
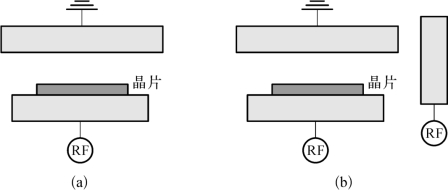
图6-6 RIE设备
(a)RIE设备(b)三极式RIE设备
2.磁场强化活性离子刻蚀机
如图6-7所示,MERIE是在传统的RIE中加上永久磁铁或线圈,产生与晶片平行的磁场,此磁场与电场垂直。电子在该磁场作用下将以螺旋方式运动,如此一来,可避免电子与腔壁发生碰撞,增加电子与分子碰撞的机会并产生较高密度的等离子体。然而,因为磁场的存在,将使离子与电子的偏折方向不同而分离,造成不均匀性及天线效应的产生,所以磁场常设计为旋转磁场。MERIE的操作压力与RIE相似,约在1~100 Pa之间,所以也不适合用于小于0.5μm以下线宽的刻蚀。
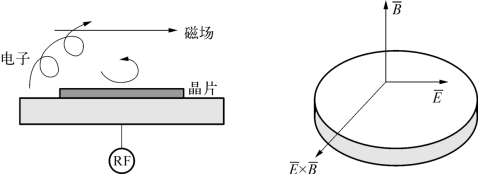
图6-7 磁场强化RIE设备
3.电子回旋共振式等离子体刻蚀机
ECR是利用微波及外加磁场来产生高密度等离子体。电子回旋频率可用式(6-1)表示
![]()
式中,ve是电子的速度;r是电子的回旋半径。
另外,电子回旋是靠劳伦兹力实现,即
![]() (https://www.xing528.com)
(https://www.xing528.com)
式中,e是电子的电荷;Me为电子质量;B是外加磁场的磁场强度。由公式(6-2)可得
![]()
将式(6-1)代入式(6-3),可得电子回旋频率为
![]()
当频率ωe等于所加的微波频率时,外加电场与电子能量发生共振耦合,因而产生很高的离子化程度。较常使用的微波频率为2.45 GHz,所需的磁场应为0.0875 T。
ECR结构如图6-8所示,微波由微波导管穿过由石英或Al2O3制成的窗口进入等离子体产生腔中,另外磁场随着与磁场线圈距离增大而缩小。电子便随着变化的磁场向晶片运动,正离子则是靠浓度梯度向晶片扩散,通常在晶片上也会施加一个RF或直流偏压用来加速离子,提供离子撞击晶片的能量,借此达到非等向性刻蚀的效果。ECR最大的限制在于其所能使用的面积。因为激发等离子体的频率为2.45 GHz,波长只有10 cm左右,因此有效的晶片直径大约为6英寸。
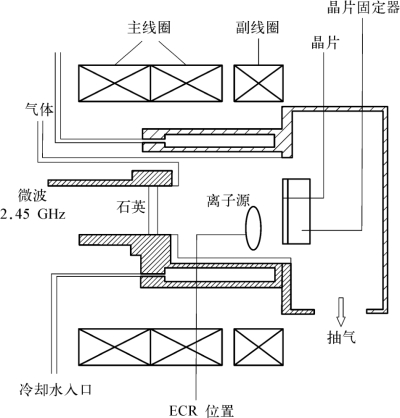
图6-8 电子回旋共振等离子体刻蚀机结构
4.感应耦合式等离子体刻蚀机与螺旋波等离子体刻蚀机
ICP的结构如图6-9所示,在反应器上方有一介电层窗,其上方有螺旋缠绕的线圈,通过此感应线圈在介电层窗下产生等离子体。等离子体产生的位置与晶片之间只有几个平均自由程的距离,故只有少量的等离子体密度损失,可获得高密度的等离子体。
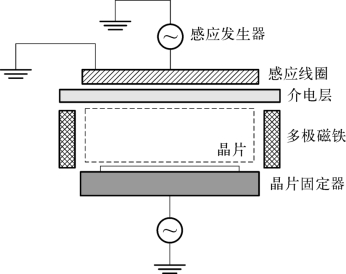
图6-9 感应耦合等离子体刻蚀机结构
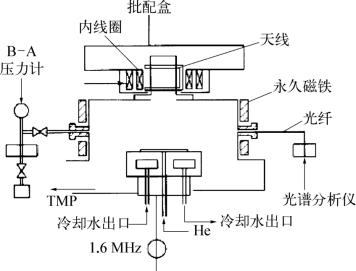
图6-10 螺旋波等离子体刻蚀机结构
螺旋波等离子体刻蚀机的结构如图6-10所示,它有两个腔,上方是由石英制成的等离子体来源腔,下面是刻蚀腔。等离子体来源腔外面包围了一个单圈或双圈的天线,用以激发13.56MHz的横向电磁波,另外在石英腔外圈绕有两组线圈,用以产生纵向磁场,并与上面所提的横向电磁波耦合产生共振,形成所谓的螺旋波,当螺旋波的波长与天线的长度相同时,便可产生共振。采用这种方式,电磁波可将能量完全传给电子,从而获得高密度的等离子体。然后等离子体扩散到刻蚀腔中,离子可被刻蚀腔中外加的RF偏压加速,而获得较高的离子轰击能量。等离子体扩散腔外围绕着大小相等方向相反的永久磁铁,如图6-11所示,目的在于避免离子或电子撞击在腔壁上。
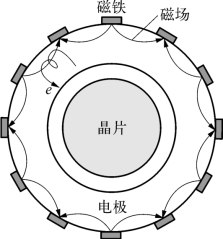
图6-11 刻蚀腔外磁场
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




