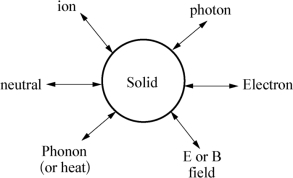
图5-54 表面分析方法的特征
注:输入箭头表示探测粒子或手段,输出箭头表示发射粒子或波。
成分分析的基本原理是利用某种激发源作为一种探测束,有时还加上电磁热等的作用,使待测样品发射携带元素成分信息的拉子,实现化学组成、状态等方面的分析。到目前为止,对薄膜结构和成分分析的研究方法已达一百多种,它们的共同特征都是(见图5-54):利用一种探测束,如电子束、离子束、光子束、中性粒子束等,有时还加上电场、磁场、热等的辅助,从样品中发射或散射粒子波,这些发射的粒子可以是电子、离子、中性粒子、光子或声波,入射到靶上的粒子束或者发生弹性散射,或者引起原子中电子的跃迁。散射粒子或出射粒子的能量包含原子的特征,跃迁能量是已知原子的标识,因此,测量出射粒子的能量谱即识别了原子。通过检测这些粒子的能量、动量、荷质比、束流强度等特性,或波的频率、方向、强度、偏振等情况的分析,可以得到材料化学组成、原子结构、原子状态、电子状态等信息。
下面给出一些实际例子:
①电子入、电子出:俄歇电子能谱(AES);
②离子入、离子出:卢瑟福背散射(RBS);
③X射线入、X射线出:X射线荧光光谱(XRF);
④X射线入、电子出:X射线光电子谱(XPS);
⑤电子入、X射线出:电子探针分析(EMA);
⑥离子入、靶离子出:次级离子质谱(SIMS)。
在此就出、入离子的种类和对应的成分表征的功能介绍几种常用的成分表征方法。
1.Auger电子能谱

图5-55 AES
如图5-55所示,Auger电子能谱(AES)是一种利用高能量电子束作为激发源的高灵敏度表面分析技术。由电子束激发产生的能量,刚好满足原子外围电子的束缚能,使电子恰能脱离并产生“Auger”电子。发射Auger电子所需的动能主要是由样品表面5~10 nm范围内的元素所决定。
电子束可以扫描一个可变尺寸的区域,或是直接聚焦在感兴趣的小面积区域。可将电子束聚焦在直径为10~20 nm区域的能力,使得Auger成为在分析小面积的样品表面元素特性是非常有用的工具。与离子溅射源结合使用时,Auger就可以分析样品表面组成的深度分布。Auger在冶金研究方面也具有广泛的应用,包括测量电解抛光医疗器械的氧化层层厚度。
2.二次离子质谱
如图5-56所示,二次离子质谱(SIMS)可以探测浓度非常低的掺杂和杂质,也可以提供从几Å到几十μm范围内的元素深度分布。样品通过使用一次离子(通常是O或者Cs)来进行溅射/蚀刻,在溅射过程中形成的二次离子可以利用质谱仪(通常是四极矩或者磁性分析器)来进行提取和分析。二次离子的浓度范围从基质到低于ppm等级。

图5-56 SIMS
3.拉曼光谱分析
拉曼光谱分析(Raman)(见图5-57)可用于确定样品的化学结构,并藉由测量分子振动来鉴定化合物,类似于傅里叶红外光谱(FTIR),而Raman具有更好的空间解析度,可以分析较小的样品。Raman是一个很好的技术,可用于有机和/或无机混合材料的定性分析,也可以用于半定量和定量分析。

图5-57 Raman
(1)鉴定在块状和单颗微粒的有机分子、聚合物、生物分子和无机化合物。
(2)Raman成像和深度分析可以得到混合物的成分分布图,如药物的赋形剂、片剂、药物释放支架涂层。(https://www.xing528.com)
(3)确定不同类型的碳(钻石、石墨、非晶碳、类钻碳、纳米碳CNT管等),以及它们的相对比例,特别适合CNT类型的成分研究。
(4)确定无机氧化物及其价态。
(5)测定半导体以及其他材料的应力和晶体结构。
4.聚焦离子束
聚焦离子束(FIB)仪器使用聚焦良好的离子束对样品作修改与取得图像。如图5-58所示,FIB主要是在通过SEM、STEM和TEM成像后,取得非常精确的样品横截面或是执行电路修改。此外,FIB可以侦测来自离子束或电子束的发射电子,用于直接成像。FIB的对比度机制与SEM和S/TEM有所不同,因此在某些情况下就可以获得独特的结构信息。双束Dual Beam是将FIB/SEM两种技术结合成一个工具,利用FIB准备样品并且使用SEM、TEM或STEM仪器得到电子影像,而Single Beam的FIB只有一个离子束源。

图5-58 FIB
FIB也是一种样品制备工具,可以准确地制造出样品的横截面,FIB可以为TEM样品提供样品制备,FIB制备样品被广泛使用在SEM中,其制样使SEM成像和元素分析可以发生在同一个多技术的机台中,在AES中也可以使用FIB制备样品,能快速而精确地提供表面的元素鉴别,当样品为小面积且难以获取时FIB是理想工具。这种情况常出现在半导体行业的FA分析中。(详见第9章9.5.1微分析技术及缺陷改善工程)

图5-59 SEM
5.扫描电子显微镜
扫描式电子显微镜(SEM)为样品表面和近表面提供高分辨率和长景深的图像(见图5-59)。由于能够快速提供非常详细的图像,SEM目前是最广泛使用的分析工具之一。与EDS(能量色散X射线光谱)的结合测量,让SEM可以提供几乎整个周期表的元素鉴定。SEM的应用范围包括故障分析、维度分析、制程特性、逆向工程和粒子鉴定。更多的SEM设备介绍请参阅“晶片的测试分析技术”章节。
6.穿透式电子显微镜/扫描穿透式电子显微镜
穿透式电子显微镜/扫描穿透式电子显微镜(TEM/STEM)是密切相关的技术,主要是使用电子束让样品成像。使用高能量电子束,超薄样品的图像分辨率可以达到1~2Å的分辨率。与SEM相比,TEM和STEM具有更好的空间分辨率,并且能够作额外的分析测量,但需要更多的样品制备(见图5-60)。尽管与其他常用的分析工具相比,需要花费更多分析时间,但是通过TEM和STEM可以获得更丰富的信息。不仅可以获得出色的图像分辨率,也可以得到晶体结构特性、结晶取向(通过绕射实验)、产生元素图(使用EDS或EELS),并且得到明显的元素对比图(暗场模式),这些方式都可以精确地定位到纳米等级的区域进行分析。TEM和STEM是薄膜和集成电路样品的故障分析工具。

图5-60 TEM
7.能量色散X射线光谱

图5-61 EDS
能量色散X射线光谱(EDS)是一种可以与扫描电子显微镜、透射电子显微镜和扫描透射电子显微镜配合使用的分析技术(见图5-61)。当EDS和这些影像工具结合到一起时,可以提供直径小至nm的区域进行元素分析。电子束对样品的撞击会产生样品元素的特性X射线,EDS分析可用于确定单点的元素成分,或者绘制出成像区域元素的横向分布。更多的EDS介绍请参阅第9章“9.4.3常用微分析仪器介绍”相关内容。
8.原子力显微镜
原子力显微镜(atomic force microscope,AFM),也称扫描力显微镜(scanning force microscopy,SFM)是一种纳米级高分辨的扫描探针显微镜,优于光学衍射极限1000倍,提供原子或近原子分辨率的表面形貌图像,能够定量样品的表面粗糙度到“Å”等级(见图5-62)。除了提供表面图像之外,AFM也可以提供形态的定量测量,如高度差和其他尺寸。另外,磁力显微镜(MFM)是AFM一种应用,能够绘制样品的磁域图。AFM分析方法常用的案例包括:评估芯片处理前后的差异(SiO2,GaAs,SiGe等),供三维表面形态影像,包括表面粗糙度、粒径大小、高度差和间距。

图5-62 SPM/AFM
AFM是纳米尺度操作材料,及其成像和测量最重要的工具。AFM通过检测待测样品表面和一个微型力敏感组件之间的极微弱的原子间相互作用力来研究物质的表面结构及性质。将一对极端敏感的微悬臂一端固定,另一端的微小针尖接近样品,这时它将与其相互作用,作用力将使得微悬臂发生形变或运动状态发生变化。信息是通过微悬臂感受和悬臂上尖细探针的表面的“感觉”来收集的,而压电组件可以控制样品或扫描器非常精确的微小移动,用导电悬臂(cantilever)和导电原子力显微镜附件则可以测量样品的电流偏压;更高级的仪器则可以测试探针上的电流来测试样品的电导率或下表面的电子的移动,不过这种测试是非常艰难的,只有个别实验室报道了一致的数据。扫描样品时,利用传感器检测这些变化,就可获得作用力分布信息,从而以纳米级分辨率获得表面结构信息。AFM就是利用微悬臂感受和放大悬臂上尖细探针与受测样品原子之间的作用力,从而达到检测的目的,具有原子级的分辨率。由于原子力显微镜既可以观察导体,也可以观察非导体,从而弥补了扫描隧道显微镜的不足。原子力显微镜(AFM)与扫描隧道显微镜(STM)最大的差别在于并非利用电子隧穿效应,而是检测原子之间的接触、原子键合、范德瓦耳斯力或卡西米尔效应等来呈现样品的表面特性。
原子力显微镜的前身是扫描隧道显微镜,是由IBM苏黎世研究实验室的海因里希·罗雷尔(Heinrich Rohrer)和格尔德·宾宁(Gerd Binnig)在20世纪80年代早期发明的,之后凭此获得了1986年的诺贝尔物理学奖。比宁(Binning)、魁特(Calvin Quate)和格勃(Gerber)于1986年发明第一台原子力显微镜,而第一台商业化原子力显微镜于1989年生产。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




